
用专业的服务做您坚实的后盾 提供7X24小时的技术支持,根据需求定制个性化服务。

用专业的服务做您坚实的后盾 提供7X24小时的技术支持,根据需求定制个性化服务。


新闻中心>行业资讯>QV HYPER Pro | 三丰仪器如何解决半导体倒装芯片测量难题
QV HYPER Pro | 三丰仪器如何解决半导体倒装芯片测量难题
2024-06-29
到2028年,半导体先进封装行业规模预计将达到674亿美元。
而在快节奏的半导体封装领域中,有一种技术在效率、性能和小型化方面脱颖而出,成为领先者:倒装芯片。
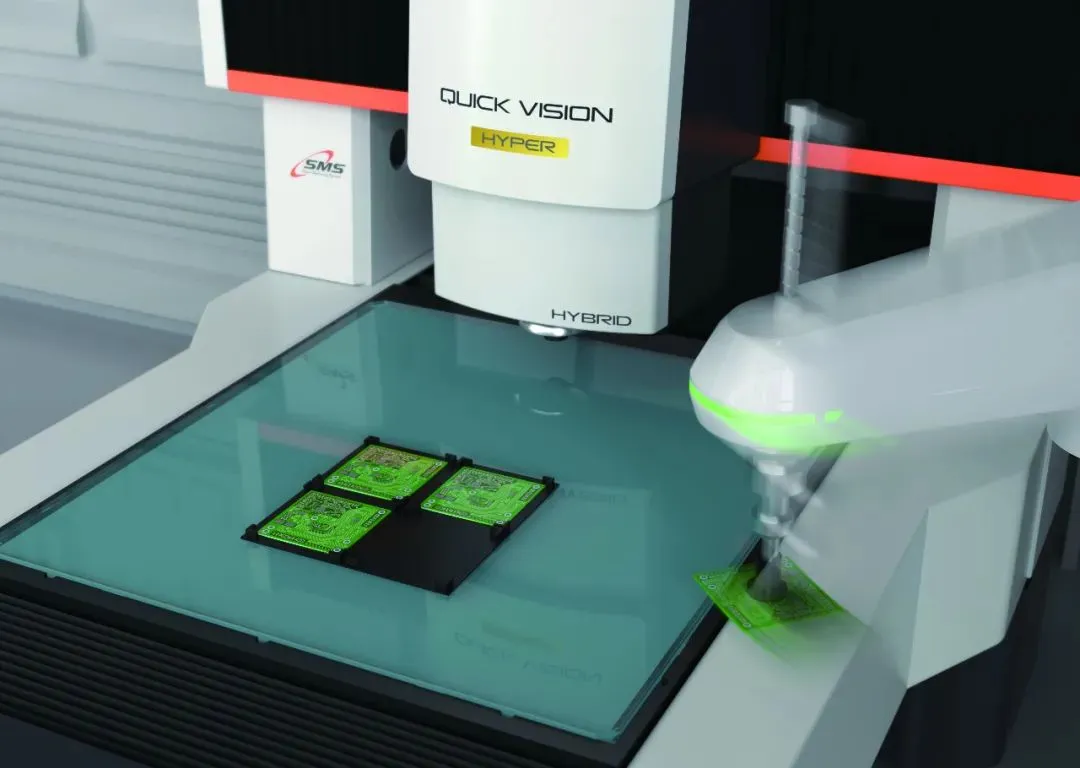
三丰的高精度影像测量机,长期服务于全球制造业而获得的经验积累,为倒装芯片快速的测量需求提供了理想的解决方案。
倒装芯片检测方案
工件用途
Purpose of the workpiece
倒装芯片将芯片上导电的凸点与线路板上的凸点进行连接,相连过程中,由于芯片的凸点是朝下连接,因此称为倒装。倒装芯片大量应用于高端物联网设备等电子产品中,是构建智能化产品的基础单元之一。
测量项目
Measurement items
芯片表面的平整程度会影响其连接效果,大多数半导体厂商会以倒装主板中心点为原点,对各测量部位相对于原点的X方向和Y方向的差的绝对值进行评价分析,俗称坐标差。主要测量项目:坐标差
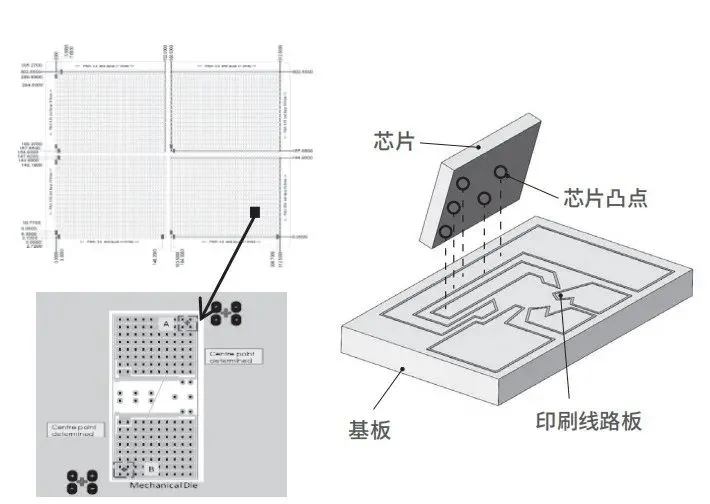
推荐机型

机器类别:
影像测量机
机器型号:
QV HYPER 404 Pro系列+STREAM 功能
测量软件:
QVPAK(影像测量机,用数据处理软件)
1.TAF功能高效对应坐标差检测
影像测量机QV Pro的TAF激光自动追踪功能,对于芯片这类非平整表面(且高度差变化不大)进行扫描时,无需停顿式对焦,从而大大提高了测量效率。
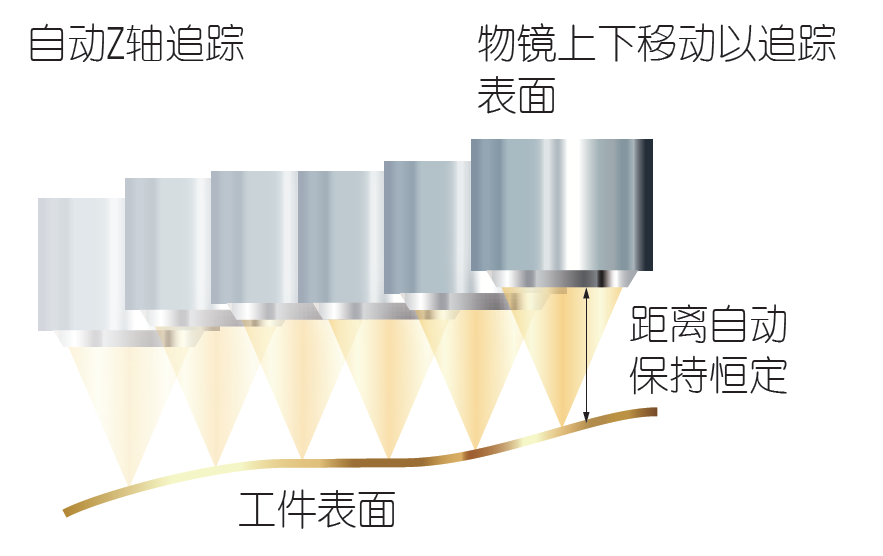
TAF:激光自动跟踪对焦,工作原理是通过物镜中的同轴激光进行自动对焦,使Z轴实时追踪到被测物的高度变化,自动进行高度调整,保证对焦清晰。
2.表面细微3D形状的高精度测量
此外,在多层基板IC组件的测量中,如需测量配线的线宽和线距、过孔直径、表面粗糙度时,还可使用白光干涉仪WLI,利用与工件之间产生的白光干涉,可实现细微领域的表面分析(粗糙度等)以及形状(数微米的不规则)的高精度
3D测量。
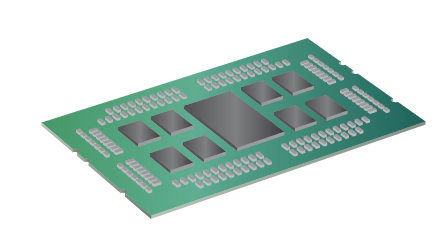
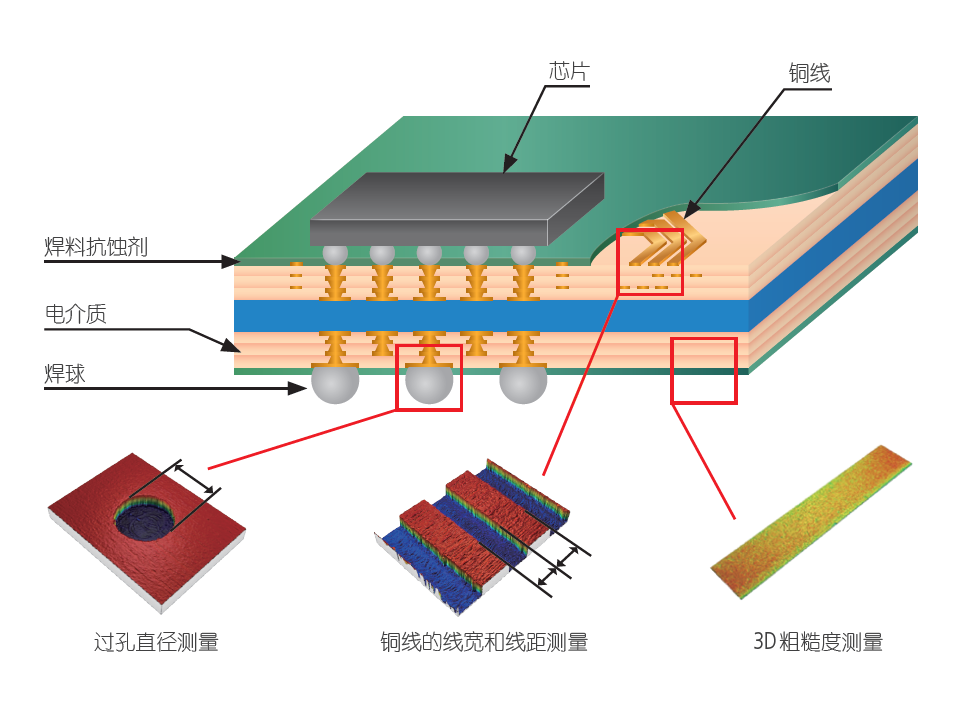
测量流程
Measurement process
Step1 在工作台上平置工件,调整照明系统(如图一所示)。
Step2 根据图纸要求创建坐标系。
Step3 在测量部位采集数据点(如图二所示)。
Step4 在OVPAK(影像测量机用数据处理软件)中进行计算,输出测量结果。

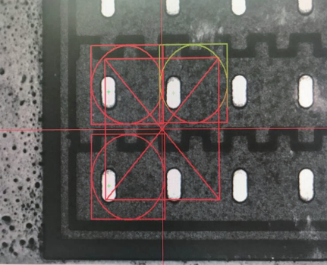
除了半导体,影像测量机QV Pro在医疗、汽车领域还有更多的应用场景,有效提高了工作效率。
如果想了解更多行业解决方案,或是想要线下亲身体验机型检测情况,欢迎后台咨询大虹客服人员!